



观察纳米级细节的快速高分辨率成像
我们的成像系统可以准确而快速地检测和分析晶圆的表面,晶圆检测显微镜可以帮助确保您制造的半导体器件发挥好的性能。 但是,进行表面计量时可能会遇到以下关键挑战: 晶圆表面可能具有高坡度的复杂结构,需要的横向分辨率,或者有微小的峰谷起伏,需要亚纳米级垂直分辨率。 利用共聚焦显微成像和干涉模式成像的徕卡成像系统可以为您提供高横向分辨率(140纳米)和垂直分辨率(0.1纳米),并且可以快速采集图像(以秒计)。

晶圆表面上的高斯型高窄凸块,通过共聚焦显微镜三维成像。 具有复杂形状或陡坡的表面特征(例如凸块)可快速生成高分辨率图像。 1:表面有凸块的晶圆 2:共聚焦显微镜扫描凸块的各个步骤(秒)3:图像
使用不同对比方法和光学元件更轻松地观察更多细节
使用我们的成像系统,在晶圆检测显微镜下,您可以更轻松地观察难以成像的晶圆特征,从而更加有效准确地进行晶圆检测和质量控制。图像对比度和细节分辨的质量在很大程度上取决于所用的照明和光学元件。 因此,选择合适的照明对比方法,并使用经过好的校正的高性能光学元件是至关重要的。 不同的晶圆和器件特性,例如涂层、污物、刮痕和缺陷等,与其他方法相比,单照明对比方法更能增强观察效果。

对于非常光滑的晶圆表面,干涉成像可以0.1纳米的分辨率呈现表面结构。 整个扫描时间不到3秒。
高性能光学元件
在晶圆检测显微镜中使用高质量光学元件可以更有效地检测晶圆和半导体器件,因为您只需花费较少的精力便可观察到微小的细节。 徕卡显微系统公司的成像系统使用性能好的的获奖光学元件,可生成无失真图像。 光学元件可能会出现2种需要校正的像差:
· 单色(不受光波长[颜色]的影响) ,如散光、彗差和场曲
· 多色(取决于光波长)。
我们的光学设计师和工程师提供性能好的的光学元件,使您能够以好的的对比度和分辨率检测晶圆和器件。

对比方法: 晶圆局部图像:a) 快速生成表面概览图, b) 明场检测颗粒,c) 暗场检测细微划痕,以及 d) 通过微分干涉差(DIC)检测透明薄膜上的缺陷。 每种照明模式下的成像在几秒钟内完成。

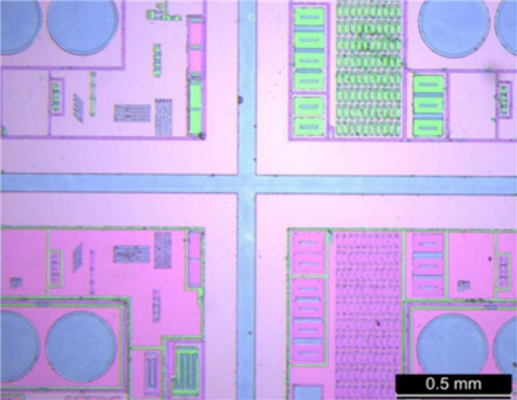
使用环形光的晶圆局部成像 使用同轴照明的晶圆局部成像
此文章来源:德国徕卡 如有涉及版权问题,请与我司联系,我司将尽快处理,谢谢